原创 芯片不是问题!1颗不行就4颗,华为“四芯片封装”技术来了
前几天,有媒体报道称,任正非面对媒体时称,芯片问题其实没必要担心,虽然单芯片落后美国一代,但通过叠加、集群等方法,计算结果是能够与最先进的水平相当的。
从这段话,大家基本上就能够看出来,那就是一颗芯片不行,我就来10颗,10颗不行就100颗,1万颗,这样叠加之后,肯定没问题的。

事实上,这种方法,在单芯片封装上也是适用的,比如苹果的M系列芯片中的 Pro、Max等,就是将多颗芯片封装在一起,实现1+1+1+1=4的这种方法。
而近日,华为多颗芯片封装在一起的技术专利曝光了,据媒体的报道,华为近期已经申请了一项“四芯片”(quad-chiplet)封装设计专利。
而在此之前,华为申请过芯片叠加的专利,这背后很明显代表着,华为已经开始将多颗芯片,封装在一起,实现1+1=2,或者1+1+1+1+4。

这种多芯片封装技术,其实是能够非常好的解决当前华为面临的问题的。
由于台积电不代工,无法得到先进工艺加持,华为只能与中芯合作,采用中芯的工艺,相比于台积电而言,肯定是落后一些。
那么在这样的情况之下,工艺不能突破,那就只能进行多芯片封装,用几颗芯片叠加在一起,实现性能上的超越。

当然,这种多芯片叠加技术,也有一定的缺点,那就是相对而言,肯定发热会大一些,然后功耗也会大一些。
但如果这种芯片,并不是用于手机这样的较小的设备之中,影响并不大的。
特别是AI芯片,由于一直采用的都是数据中心方式,通过集群来实现的,会有单独机房,单独的供电、甚至是液冷、恒温等。
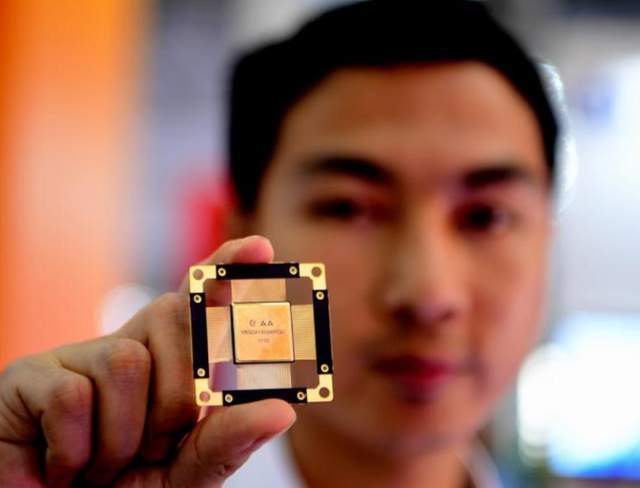
事实上,我都都清楚,当芯片进入到7nm之后, 所谓的XX纳米已经是等效工艺了,一代与另一代之间的差距,并没有那么大了。
所以如果通过7nm工艺,将多颗芯片封装在一起,肯定不会输给3nm、2nm这样的芯片。
所以任正非才会这么有底气,说芯片问题不用担心,因为华为早就有解决办法了,不管是集群还是叠加,华为都有底气与顶尖芯片PK的。
