雷军投的江苏半导体封测黑马要IPO了!年入8亿,东南大学校友创立

芯东西(公众号:aichip001)
作者 | ZeR0
编辑 | 漠影
芯东西11月4日报道,10月31日,江苏半导体封测技术解决方案提供商芯德半导体正式递表港交所。

芯德半导体成立于2020年9月,主要从事开发封装设计、提供定制封装产品以及封装产品测试服务,2024年获工信部认定为国家“专精特新小巨人”企业。
该公司具备先进封装的量产能力,涵盖QFN、BGA、LGA、WLP及2.5D/3D等,是国内少数率先集齐这些全部技术能力的先进封装产品提供商之一。
以2024年半导体封装测试收入计,芯德半导体在中国通用用途半导体组装和测试商中排名第7。
由雷军最终控制的小米长江、由全球第五大无晶圆厂芯片设计公司联发科技最终控制的Gaintech、全球智能产品ODM龙头龙旗科技,均是芯德半导体的股东。
其客户包括联发科技、晶晨半导体、集创北方、联咏科技、锐石创芯、飞骧科技、芯朴科技、慧智微、芯睿微、博通集成、中科蓝讯、南芯半导体、杰华特、英集芯、艾为电子等知名芯片企业。
值得一提的是,芯德半导体的多位董事及高管均有在国内第一大半导体封测龙头长电科技履职的背景。

一、中国通用用途OSAT排名第7,市场份额为0.6%
半导体封测的发展历史经历5个阶段,从早期的双列直插封装(DIP)到引脚被表面贴装引线取代,再到以环栅阵列(BGA)、晶圆级封装(WLP)为代表的先进无铅封装技术兴起,进一步出现系统级封装(SiP)、凸块封装等新方法浪潮,再到阶段5的倒装芯片(FC)、矽通孔(TSV)技术等进一步创新。

根据是否有封装基板及封装基板的材料,半导体封装产品可分为不同类别,每个类别均有不同的封装技术。

先进封装在传统封装的基础上,增加了提高功能密度、缩短互联长度、进行系统改造的功能,可在不依赖于芯片制造工艺的突破的情况下增加产品集成度及功能多样化。

中国半导体封装测试市场参与者众多,约150至200家OSAT(外包半导体组装和测试)公司。其中大部分OSAT主要从事传统封装测试业务。这些OSAT的整体收入规模普遍较小,先进封装测试收入占其总收入的比例相对较低。
受半导体产品多样化影响,市场上已经形成了两种OSAT,即通用用途OSAT和特定应用OSAT。
- 通用用途OSAT提供多种不同类型芯片的封装测试服务,应用于各领域,不只关注一种芯片类型,拥有灵活的能力来满足广泛的客户需求。
- 特定应用OSAT专门针对特定用途仅封装测试芯片,技术及工艺专为满足该等利基领域的独特需求而设计,而非服务于所有芯片类型及行业。
以2024年半导体封装测试收入计,芯德半导体在中国通用用途OSAT中排名第7,市场份额为0.6%。

该公司在2.5D、凸块封装(Bumping)、扇出型晶圆级封装(Fan-out WLP)、扇入型晶圆级封装(Fan-in WLP)、WB/FC-BGA、WB/FC/Hybrid/SiP-LGA、FC-QFN等技术上拥有核心量产能力,并积极推进Chiplet互联(同质异质晶片集成)、光电感测、TGV玻璃基板产品等前沿技术的研发及产业化,是国内少数几家在上述领域均具备全面能力的先进化服务提供者。

芯德半导体已搭建起覆盖先进封装领域所有技术分支的「晶粒及先进封装技术平台(CAPiC)」。
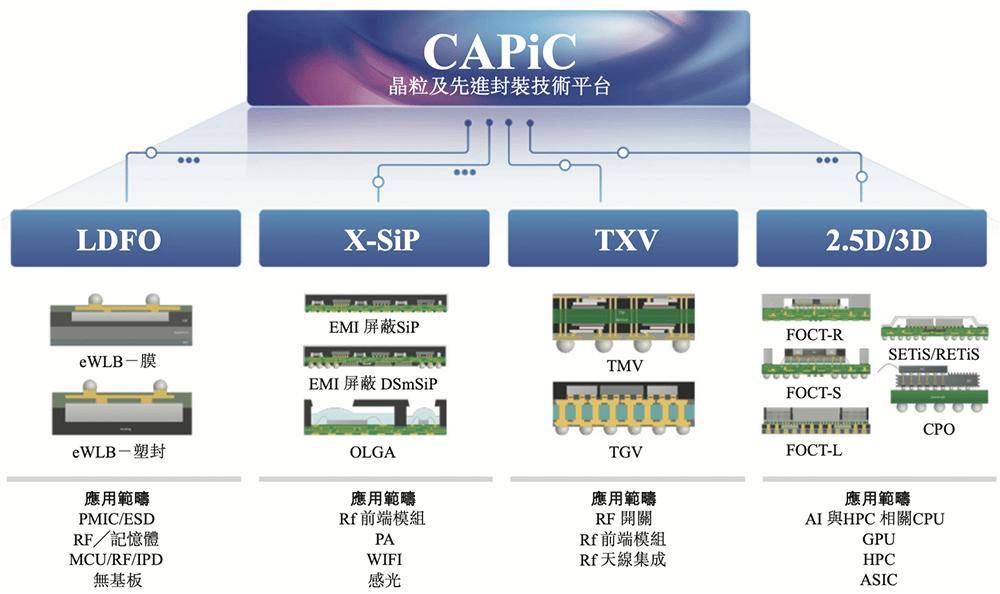
截至2025年6月30日,芯德半导体研发部门共215人,研发计划由23名核心成员领导。

截至最后实际可行日期,本集团于中国拥有211项注册专利,其包括32项发明专利及179项实用新型专利,涵盖关键领域,如封装结构化、方法学、装置和测试系统。该公司亦拥有三项PCT专利申请。
二、去年收入逾8亿元,毛损率逐年改善
2022年、2023年、2024年、2025年1-6月,芯德半导体收入分别为2.69亿元、5.09亿元、8.27亿元、4.75亿元,净利润分别为-3.60亿元、-3.59亿元、-3.77亿元、-2.19亿元,研发费用分别为0.59亿元、0.77亿元、0.94亿元、0.44亿元。

▲2022年~2025年1-6月芯德半导体营收、净利润、研发支出变化(芯东西制图)
同期,其毛损率分别为79.8%、38.4%、20.1%、16.3%,因产能及利用率提升而呈大幅改善趋势。
2025年上半年,QFN、BGA、LGA、WLP业务分别贡献了芯德半导体收入的31.0%、31.8%、20.1%、16.9%。

目前该公司向海外客户提供的服务收入不到10%。

其综合财务状况表如下:

现金流如下:

三、上半年生产25亿件,客户包括联发科技、集创北方等
截至2025年6月30日,芯德半导体拥有南京生产基地及扬州生产基地两个生产基地。

2025年上半年,南京生产基地实际产量为25.31亿件,产能利用率为77.4%。
芯德半导体在SoC、显示、射频前端、蓝牙、电源管理芯片等主要芯片领域构建起优质且多元化的客户基础,能够精准服务于人工智能、边缘计算、汽车电子、新兴消费应用等高速增长的下游市场。
在SoC领域,该公司凭借2.5D集成、WB-BGA、FC-BGA、混合BGA等先进封装技术,与行业头部企业建立了稳固的合作关系,客户包括全球五大无晶圆厂半导体公司之一联发科技以及一家中国领先的移动芯片制造商。
在显示芯片领域,芯德半导体与头部客户建立了稳固的合作关系,包括晶晨半导体和联咏科技。
在射频前端领域,该公司已掌握WB-LGA、FC-LGA及混合LGA封装技术的专业能力,吸引了锐石创芯、飞骧科技、芯朴科技、慧智微、芯睿微等多元化的客户群体。
在蓝牙领域,其采用了QFN封装技术,为相关行业的知名客户提供服务,包括博通集成及中科蓝讯。
在电源管理领域,该公司已采用QFN及WLP技术,为小型化、高效率的芯片设计提供支持。这些先进解决方案促成了与南芯半导体、杰华特、英集芯、艾为电子等头部客户的合作。
芯德半导体已获得200多家直接客户及50多家终端客户的质量认证。其客户主要包括半导体设计公司的上游直接客户。
2022年、2023年、2024年、2025年1-6月,来自五大客户的收入分别占芯德半导体总收入约60.5%、50.4%、53.0%、55.2%。国内显示芯片龙头集创北方是其2023年的第四大客户,国内射频前端芯片企业锐石创芯、芯朴科技均在其2025年上半年的五大客户之列。




同期,其自五名最大供应商的购买额分别占总购买额约41.8%、30.9%、33.9%、32.6%。


四、东南大学英专生创业,多位高管为长电科技背景,小米长江、联发科技持股
芯德半导体创始人张国栋今年46岁,担任董事会主席、执行董事。
他并非科班出生,本科毕业于东南大学外语学院英语专业,2004年4月进入江阴长电先进封装有限公司,任职长达16年多,最后位列董事。
2020年9月,张国栋在江苏南京创办芯德半导体,开启半导体封测创业之路。

▲芯德半导体创始人、董事会主席、执行董事张国栋
根据招股书,潘明东自芯德半导体成立起担任董事,自2021年6月起担任总经理。他今年47岁,本科毕业于江南大学,硕士毕业于江苏科技大学,曾在长电科技(宿迁)有限公司工作19年,担任高级工程师及部门副总经理。
江阴长电先进封装有限公司、长电科技(宿迁)有限公司均由国内第一大半导体封测龙头长电科技全资控股。
包括他们在内,芯德半导体的多位董事及高管,均有长电科技任职背景。
刘怡今年46岁,2022年11月首次加入芯德半导体,目前担任执行董事、副总经理。他本硕均毕业于合肥工业大学化学工程与工艺专业,曾任职于深圳富澜微科技有限公司、长电科技管理有限公司、江苏长电科技股份有限公司、日月光集团旗下公司。
芯德半导体的职工代表董事兼副总经理龙欣江今年46岁,自2021年4月起担任芯德半导体副总经理,主要负责凸点封装及晶圆级封装测试。他本硕毕业于武汉理工大学,博士毕业于东南大学先进制造工程专业,曾在江阴长电先进封装有限公司任职15年,最后职位为厂长及生产副总经理。
芯德半导体的研发部副总经理张中今年45岁,本科毕业于南京农业大学,并通过远程学习获得英国安格利亚鲁斯金大学获得工商管理硕士学位(MBA),自2023年8月起担任南京师范大学电气与自动化工程学院讲师教授。他曾任职于矽品科技(苏州)有限公司、德州仪器半导体技术(上海)有限公司苏州分公司、长电科技先进封装有限公司。
截至最后实际可行日期,凭借一致行动人士协议,芯德半导体的单一最大股东集团(张国栋、潘明东、刘怡、宁泰芯、宁浦芯)有权于该公司股东大会上行使合共24.95%的投票权。

由雷军最终控制的小米长江、由联发科技最终控制的Gaintech、龙旗科技,都是芯德半导体的股东,分别持股2.61%、0.31%、0.29%。
2024年,芯德半导体董事薪酬如下:

结语:先进封装本地化进程将持续加快
在国际贸易环境变化及中国对自主发展半导体需求的推动下,先进封装╱测试的本地化趋势日益明显。国内企业在先进封装技术方面已取得持续突破;在设备方面,尽管高端领域本地化率仍然较低,国内制造商正加紧研发投入,部分产品已实现国产替代。
芯德半导体已建立起覆盖先进封装与测试能力的完善技术架构,具有2.5D/3D集成、凸块、倒装芯片(FC)、引线键合(WB)等多种封装技术,同时测试流程涵盖凸点前晶圆测试(PreBump-CP)、凸点后晶圆测试(PostBump-CP)及成品测试(FT)。
这一技术架构能为各类应用场景提供全流程一站式技术解决方案,包括通用处理器、高速计算芯片、射频模组、电源音频类元件、毫米波器件、光学传感器及多种密度存储产品。
其研发战略覆盖五个关键维度,构建全场景技术布局:高性能2.5D/3D封装解决方案、高精度光学传感解决方案、车规级封装技术、创新型玻璃基板技术、现有技术的迭代研发。
在第五代研发战略的指引下,该公司正加大投入力度,战略主线为以「2.5D/3D高端封装」为核心引擎,联动多维度技术协同突破,正深化CAPiC架构下LDFO、X-SiP、TXV及2.5D/3D四大技术平台建设推进FOCT-S与FOCT-L(相当于COWOS-S/L)的量产,建立完善的TGV技术矩阵,推进产品开发和应用落地。
